SMT 焊珠(Solder Beading)是指在回流焊接过程中形成的与主焊点分离的微小焊料颗粒,其直径通常小于0.13mm。这些细小的焊料球可能分布在焊盘周围、元件底部或PCB表面,是表面贴装技术中最常见的焊接缺陷之一。
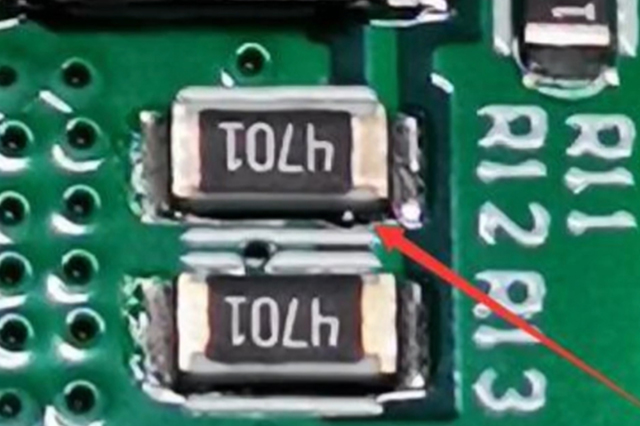
焊珠的形成主要源于焊膏中金属颗粒在回流过程中未能有效聚结。当焊膏中的氧化物含量过高时,会阻碍焊料颗粒之间的熔合,导致部分焊料以孤立小球的形式存在。此外,过快的加热速率会导致溶剂剧烈挥发,将焊料颗粒"炸开"形成飞溅。
1、工艺与设计原因分析
1.1 设计因素
焊盘设计缺陷:不合理的焊盘尺寸比例(如长宽比不当)会导致焊膏释放不均匀
阻焊层问题:阻焊层与焊盘对齐不良(偏差>0.05mm)会造成焊膏扩散异常
元件布局:高密度组装时相邻焊盘间距不足(<0.2mm)易产生桥接和焊珠
1.2 材料因素
焊膏质量问题:
金属含量过低(<88%)
助焊剂活性不足(RA等级不匹配)
粉末氧化度超标(>0.5%)
粒径分布不合理(Type3焊膏用于细间距焊接)
存储条件不当:
暴露在高温(>25℃)高湿(>60%RH)环境
超过开封有效期(通常>8小时)
1.3 工艺控制因素
印刷工艺:
钢网与PCB对位偏差(>50μm)
刮刀压力不当(建议30-60N)
脱模速度过快(>1mm/s)
贴装工艺:
Z轴下压力过大(导致焊膏挤压)
元件放置偏移(>25%焊盘宽度)
环境控制:
车间温湿度超出范围(理想23±3℃,40-60%RH)
2、回流焊接关键参数
2.1 温度曲线控制
预热阶段:升温速率应控制在1-3℃/秒,避免>4℃/秒的剧烈升温
保温阶段:建议维持120-160℃区间60-120秒,确保溶剂充分挥发
回流阶段:峰值温度应超过焊料熔点20-40℃,保持时间30-60秒
2.2 气氛控制
氮气保护:氧含量控制在<1000ppm可显著减少氧化
对于免清洗焊膏,推荐氮气环境(<500ppm氧含量)
3、解决方案与预防措施
3.1 设计优化
采用防焊珠焊盘设计(如添加阻流槽)
优化钢网开孔(面积比>0.66,厚径比>1.5)
选择匹配的阻焊层材料(液态光致阻焊剂优于干膜)
3.2 工艺改进
实施焊膏粘度测试(推荐值:800-1200kcps)
建立严格的钢网清洁制度(每5-10次印刷清洁一次)
采用3D SPI(焊膏检测)系统监控印刷质量
3.3 质量控制
定期进行焊膏性能测试(包括坍落度、粘着力等)
建立元件可焊性评估体系(接触角<30°为合格)
实施炉温曲线实时监控系统
4、检测与修复
4.1 检测方法
光学检测(AOI):可识别>0.05mm的焊珠
X-ray检测:适用于隐藏焊珠的发现
电气测试:检测由焊珠引起的短路故障
4.2 修复技术
微喷清洗:适用于高密度组装板
局部返修:使用热风笔精确处理
激光去除:针对敏感元件的精细处理
通过系统化的原因分析和综合防治措施,可以将焊珠缺陷率控制在<200ppm的水平,满足高可靠性电子组装的要求。实际应用中建议建立缺陷分析数据库,持续优化工艺参数。
